复旦大学材料科学系王珺教授课题组,主要研究方向为微电子封装可靠性、新型电子材料、材料测试表征等,包括先进微电子封装模拟仿真和可靠性设计、新材料开发研究、材料性能表征方法及材料失效分析、封装关键技术研究、电子封装可靠性数据库应用研究等。已发表90余篇SCI、 EI/ISTP及国内核心研究论文,已获授权十多项国内专利和三项软件著作权。
╱ 研究领域 ╱
微电子封装可靠性、新型电子材料、材料测试表征、可靠性实验
[项目] 更“可靠”的电子封装可靠性研究
╱ 项目背景 ╱
微电子封装是将集成电路裸芯片组装为可实现特定功能的电子器件、电路模块和电子整机的制造技术。封装体具有保护芯片不受或少受外界环境的影响、实现芯片与外界的电气互连等功能。封装器件需要通过各种电、热、机械测试,确保器件的可靠性,使之具有稳定的、正常的功能。
近年来,随着人工智能等新兴应用需求快速增长,一方面,消费电子等终端产品对设备需求越来越小型化,对应的芯片封装尺寸要求也越来越高;另一方面,5G、高性能运算、智能驾驶、AR/VR、物联网等对芯片的性能提出了更高的要求,对芯片封装密度要求也越来越高。
这些新兴应用推动了先进封装迅速发展,例如多芯片高密度集成、三维异质异构集成、光电合封等,封装工艺从毫米工艺走向微米工艺,由于先进结构复杂、高密度、涉及众多有机、无机材料,因此,器件可靠性设计面临巨大的挑战。
针对先进封装设计和制造相关的可靠性设计,发展高效率、高精度、降低实验成本的封装可靠性分析、评估方法至关重要。
╱ 项目内容 ╱
课题组围绕多种先进封装形式,包括细节距倒装芯片、叠层芯片封装、TSV三维集成等,通过模拟仿真和实验研究相结合的方法,已经开展了大量先进封装中的热-机械应力分析、热传导分析、湿热应力分析、焊点疲劳寿命分析、跌落冲击模拟、封装基板翘曲预测等问题的研究,涉及几何/材料非线性、断裂分析、多物理场分析等分析方法。
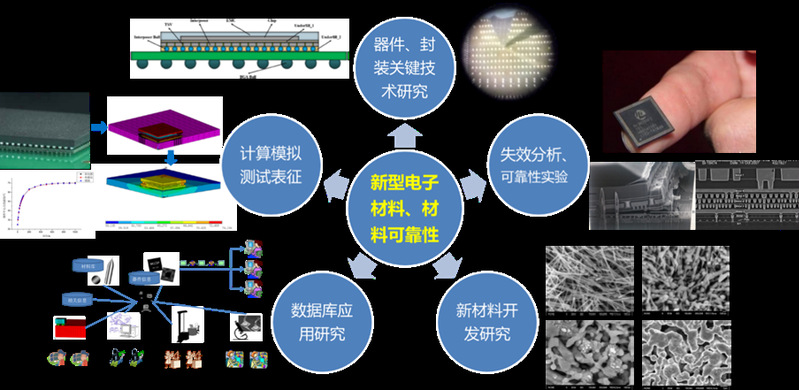
在仿真和实验相结合的研究中,需要进行材料测试表征、器件可靠性测试和失效分析、验证模型的计算仿真等方面的研究,获得器件内部关键物理量的变化规律,揭示影响产品可靠性的各种重要因素,由此建立封装器件可靠性评估方法和提出可靠性改善建议。
此外,在开发新材料、新产品时,将可靠性设计融入到集成电路先进封装器件设计中,可以大大缩短开发周期,降低成本。针对大量材料测试、可靠性测试和模拟仿真研究结果有序整理的困难,课题组进行了电子封装数据库的应用开发尝试,包含封装材料、器件可靠性实验和仿真等结果,便于查询和使用。
本课题组围绕电子封装研究,已申请并获授权10余项中国发明专利。
╱ 项目总结 ╱
综上所述,本课题组长期从事微电子封装可靠性研究,通过材料测试表征、可靠性实验和模拟仿真方法相结合,积累了一些高效率、高精度的检测方法,通过模拟仿真手段有效减少实验的数量和实验时间,显著降低实验成本,提供有效的封装可靠性评估和可靠性改善建议。
希望与微电子领域企业单位合作,提供优质的测试分析、模拟仿真等应用基础研究服务,并提供综合性方案和建议。
以上发布内容未经授权,请勿转载!

 首页
首页 搜索
搜索





